


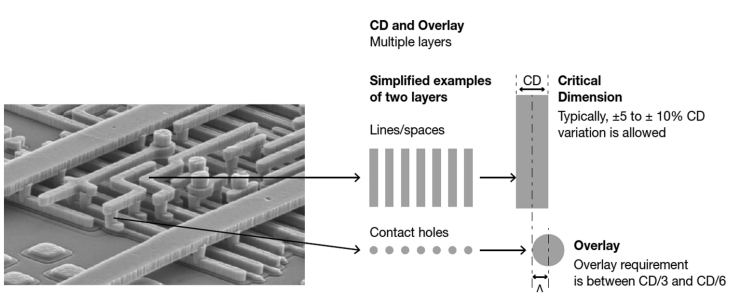
EUV 스캐너의 동작원리.. 뭐뭐뭐 설명하기전에 우선 반도체 산업, 특히 포토리소그래피에서 중요하게 여겨지는 두가지를 살펴보겠습니다. 그리고 관련 설명을 이어나가겠습니다. 모두 스캐너에 대한 심화내용을 설명하기 앞서 필요한 사전정리입니다. ^^
1. 이미징
이미징은 특정 IC 레이어를 정확하게 표현하는 프로세스입니다. 근본적으로 정밀도에 관한 것입니다. 피처가 작을수록 같은 공간에 더 많은 트랜지스터를 집적할 수 있으므로 컴퓨팅 성능이 향상되고 전력 사용량이 감소하는 성능 좋은 제품을 만들 수 있죠. 2등제품을 좋아하는 사람은 없죠. 1등만이 살아남는 세상. 그게 바로 반도체입니다.
2. 오버레이
오버레이 측면은 각 후속 레이어를 이전 레이어 위에 최대한 정밀하게 쌓을 수 있는 기능을 말합니다. 여기에는 전체 칩 영역에 걸쳐 라인과 접점을 정확하게 정렬하는 작업이죠. IC의 각 레이어가 이미징될 때, 새 레이어가 기존 레이어에 완벽하게 오버레이되어야 하며, 오차 범위는 수 나노미터 미만이어야 하죠. 정렬이 잘못되면 전기적 결함이 발생하거나 제조 수율이 낮아집니다. 이렇게 되면 이윤을 추구하는 기업에게는 치명적이겠죠?
Imaging
상술하였듯 이미징은 마스크의 템플릿이 웨이퍼의 레지스트에서 이미지로 얼마나 잘 재현되는지에 관한 것입니다. 해상도가 높을수록 복잡한 다중 노출을 방지할 수 있기 때문에 EUV 노광 툴의 분명한 장점입니다. 또한 패턴 재현성은 한 가지 수치로 표현하기는 EUV 쪽이 어렵지만 훨씬 더 우수합니다. 일반적으로 노광 시스템의 이미징 품질을 표현하기 위해 몇 가지 지표를 사용합니다. 자주 사용되는건 임계 치수(CD)입니다. 레일리 방정식에 의해 계산되죠

또한 콘트라스트(대비비)를 표현하는 데 자주 사용되는건 NILS입니다

NILS는 선폭과 무관한 콘트라스트 메트릭이므로 콘트라스트에 매우 유용한 메트릭입니다. 적절한 이미징을 위해서는 특정 NILS 값이 필요합니다. EUV에서는 일반적으로 최소값 2를 경계 조건으로 삼지만 특정 상황에서는 더 큰 값이 필요하죠. 좋은 대비는 좋은 Aerial 이미지로 이어지며, 이는 필드 웨이퍼에서 CD 분포를 제어하는 데에도 중요합니다.
또한 이미지 콘트라스트가 높으면 마스크 오류 계수가 감소하여 마스크 쓰기 오류로 인한 웨이퍼의 CD 오류가 줄어듭니다. 웨이퍼의 CD 분포를 CD 균일성(CDU)이라고 합니다. CDU는 초점 및 광(도즈) 오차로 인한 소위 global 부분과 일반적으로 로컬 CDU(LCDU)라고 하는 로컬 부분의 두 부분으로 구성됩니다. 이는 광자의 확률적 동작의 결과이며(Shot noise 개념을 아시면 좋습니다.) 매우 국지적인 동작을 보여 주며 각 개별 피처는 고유한 크기를 갖습니다.

웨이퍼의 모든 위치에서 도착하는 광자의 수는 이 확률적 거동에 의해 부분적으로 결정됩니다. 이 확률적 국소 광량은 콘트라스트를 통해 국소 CD로 변환됩니다. 특정 노출 광량에서 국소 CD를 결정하는 광자의 수는 패터닝 할 피처의 크기에 따라, 그리고 광자당 에너지에 반비례하여 스케일링됩니다. EUV의 도입으로 광자당 에너지는 6.42eV(193nm)에서 91.84eV로 증가했습니다.
즉, 주어진 광량에서 이전 대비 광자의 수가 14배나 감소한 것입니다. 또한 패터닝 할 수 있는 피처도 감소하고 있습니다. LCDU는 이미지 콘트라스트와 광량의 함수로써 정의되는데, LCDU는 패터닝의 콘트라스트에 의해 낮아지고 1/NILS에 거의 선형적으로 대응합니다. LCDU는 특정 피처 크기에서 광량 불확실성의 샷 노이즈 특성을 나타내는 1/sqrt(광량)으로써 정의되며 노출 광량에 의존합니다. 이러한 효과를 조합하면 아래의 방정식처럼 되죠.

Focus and dose

이미징 시스템에서 CD는 일반적으로 인쇄된 이미지의 초점이 얼마나 잘 잡혔는지와 적용된 광량에 매우 민감합니다. 이 동작을 표현하는 일반적인 방법은 process window(프로세스 창)이라고 하는 것으로, 위 그림과 함께 설명하겠습니다. 기본 형태에서 프로세스 창은 두 개의 곡선으로 구성되는데, 하나는 피처가 10% 크게 프린트되는 초점과 광량 값을 결정하고, 다른 하나는 피처가 10% 작게 프린트되는 초점과 광량 값을 선정?(결정)합니다. 이에 따라서 두 곡선 사이의 영역은 피처 CD가 ±10% 이내에서 인쇄되는 모든 초점 및 광량 조합을 나타내게 되죠(당연하게도 ^^,).
일반적으로 광량과 초점이 정규 분포로 간주되는 경우를 나타내기 위해 이 영역 안에 타원을 맞춥니다. 허용 가능한 초점 범위는 일반적으로 초점 깊이(DOF)라고 하고, 허용 가능한 광량 범위를 exposure latitude라고 하며 상대적인 수치로 표시합니다. 위 그림에서 exposure latitude가 10%로 유지되는 한 가지 예만 나와 있지만, 사실 많은 타원을 적용할 수도 있습니다.
그리고 exposure latitude가 더 큰 타원은 DOF가 더 작아집니다. 여기선 0.33-NA 시스템으로 패터닝된 20nm iso space와 0.55-NA 시스템으로 패터닝된 피처의 두 가지 상황의 프로세스 창이 나와 있죠?, 여기서 피처 크기는 NA에 따라 바뀝니다. 두 수치를 비교하면 두 상황에서 필요한 광량 제어는 비슷하지만 0.55-NA의 경우 훨씬 더 엄격한 초점 제어가 필요하다는 것을 알 수 있습니다. 이 프로세스 창만 잘 그려도 NA가 증가할 때 초점 제어가 리소그래피 스캐너 시스템 설계의 주요 구동 매개변수 중 하나라는 것을 알 수 있습니다.


레일리 DOF 방정식에 따라 NA가 클수록 DOF가 작아지고, 이를 통해 NA 0.33에서 NA 0.55로 이동하면 DOF가 약 3배 감소합니다. 따라서 EUVL 스캐너에 필요한 초점 제어 기능도 이 수치에 따라 확장되어야 하죠. 차세대 EUVL 스캐너의 NA는 0.55입니다.(NEX 3600일겁니다 2024년 릴리즈한다던데.. 비싸겠다.. 정말) 아마 이 설비의 초점 제어는 목표 값은 약 30nm가 되겠죠?.
Overlay
칩의 개별 레이어가 서로 얼마나 잘 정렬되는지를 오버레이라고 합니다. 이런 오버레이 성능?을 나타내는 지표를 온-프로덕트 오버레이(OPO)라고 합니다. 즉 OPO는 구조가 레지스트에 있는 제품 웨이퍼에서 측정된 오버레이 오차를 나타냅니다. 리소그래피 공정에서 많은 방해 소스로 인해 오버레이 오류가 발생할 수 있습니다. 이러한 오류는 오류의 성격에 따라 네 가지 범주로 분류할 수 있습니다.
처음 세 가지 유형의 오류는 노광 설비에서 발생하며, 네 번째 유형은 설비 외부에 오류 원인이 있습니다.
1. 척 오류. 동일한 스캐너와 척, 동일한 마스크, 동일한 노출 설정을 사용하여 두 개의 레이어를 노출할 때 나타나는 오류입니다. 이 범주는 노출설비의 기본적인 재현성을 나타냅니다. 오차의 원인으로는 시스템 동역학, 서보 성능, 위치 측정 노이즈 등이 있습니다.
2. 기계 오류. 서로 다른 노출 설비에서 두 개의 동일한 레이어(동일한 마스크 및 노출 설정)를 노출할 때 나타나는 오류입니다. 이 범주는 서로 다른 도구가 얼마나 잘 닮았는지? (비슷하다고 말을 해야하나..)를 나타냅니다. 오차의 원인으로는 광학계의 왜곡 변화와 시스템 보정 정확도가 있겠네요
3. Apps 오류. 이 오류는 동일한 노출 설비에서 두 개의 레이어를 노출하지만 각 레이어에 대해 다른 노출 설정과 다른 마스크를 사용할 때 나타납니다. 이 범주는 노광 설비가 여러 작업 지점에서 얼마나 잘 작동하는지를 나타냅니다. 원인은 설비 내부에 있습니다. 예를 들어 렌즈 수차, 마스크 및 웨이퍼 가열 효과 등이 있죠.
4. 프로세스와 오류. 이러한 오류의 원인은 외부에 있습니다. 노광 툴과 계측 툴 사이에서 실행되는 APC 루프의 불완전성으로 인해 발생합니다. 이러한 루프는 공정으로 인한 오버레이 오류(예: inplane wafer deformations)를 수정하는 데 사용됩니다. 또한 공정 파라미터의 큰 변화에 대한 시스템의 신뢰성?을 보여줍니다. 예를 들어 인플레인 웨이퍼 변형, 마스크 writing 오류, 정렬 마크 변형, 계측 툴 측정 노이즈 등이 있습니다. 각 오류 원인은 본질적으로 확률론적이며 상호 상관관계가 없습니다. 모든 확률적 오류를 더하면 많은 머신과 애플리케이션에 노출된 많은 웨이퍼에 대한 오버레이 오류의 가우스 분포 평균으로 나타나게 됩니다.
Edge placement
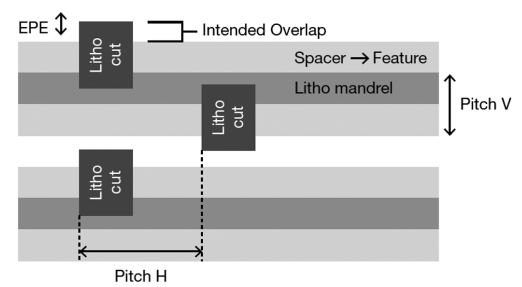
edge placement error (EPE)는 모든 오버레이 및 CD 오차를 결합한 지표입니다. 시스템적 오류(OPC, 툴-툴), local 확률적 오류 및 global 오류의 합본?이고 이러한 오류와 노출 해상도가 함께 패터닝될 수 있는 패턴 밀도를 결정합니다. 이 접근 방식은 특히 로직 애플리케이션에서 자주 사용됩니다. 즉 EPE 요구 사항에 따라 오버레이, CDU, LCDU 및/또는 선폭 거칠기(LWR)가 결정됩니다. 오버레이와 CDU는 대부분 광량과 무관하지만, 달성 가능한 LCDU는 주로 빛의 샷 노이즈에 의해 좌우되므로, 상술된 설명처럼 절대 광량에 크게 의존합니다.(EUV, 광자 수, 엄 청 적 다! 필 수!)
'Semiconductor > EUV lithography' 카테고리의 다른 글
| 36. EUV Scanner에 대하여 (3) (3) | 2023.11.02 |
|---|---|
| 35. EUV Scanner에 대하여 (2) (1) | 2023.11.01 |
| 33. EUV Mask에 대하여 - 종류 (5) (1) | 2023.10.30 |
| 32. EUV Mask에 대하여 - 오염 (4) (1) | 2023.10.29 |
| 31. EUV Mask에 대하여 - 흡수 (3) (1) | 2023.10.28 |



